一种智能卡封装框架,属于集成电路技术领域。包括基材(5)、基材(5)上方的接触层和基材(5)下方的焊接层,所述接触层和焊接层均为复合结构,自内向外依次为铜层(1)、镍层(2)和金层(4),其特征在于:在所述镍层(2)与金层(4)之间增加一层磷镍合金层(3)。即基材(5)两侧自内向外依次为铜层(1)、镍层(2)、磷镍合金层(3)和金层(4)。本实用新型提高了产品接触表面的耐磨性和抗腐蚀性,节约成本。

背景技术
[0002] 智能卡,也称IC卡(Integrated Circuit Card,集成电路卡)、智慧卡(intelligent
card)、微电路卡(microcircuit card)或微芯片卡等。它是将一个微电子芯片嵌入符合ISO
7816标准的卡基中,做成卡片形式。智能卡是继磁卡之后出现的又一种新型信息工具。一般常见的智能卡采用射频技术与读卡器进行通讯。它成功地解决了无源(卡中无电源)和免接触这一难题,是电子器件领域的一大突破。主要用于公交、轮渡、地铁的自动收费系统,也应用在门禁管理、身份证明和电子钱包。
[0003] 智能卡工作的基本原理是:射频读写器向智能卡发一组固定频率的电磁波,卡片内有一个LC串联谐振电路,其频率与读写器发射的频率相同,这样在电磁波激励下,LC谐振电路产生共振,从而使电容内有了电荷;在这个电容的另一端,接有一个单向导通的电子泵,将电容内的电荷送到另一个电容内存储,当所积累的电荷达到2V时,此电容可作为电源为其它电路提供工作电压,将卡内数据发射出去或接受读写器的数据。
[0004] 然而传统智能卡的缺点是制造成本较高,传统的智能卡框架为三层的层状结构,最内层为铜层,中间位镍层,表面为金层。在传统工艺下要求的厚度是:镍接触层:3±1μπι,焊接层:5±2μπι;金接触层:0.1±0.05
μ m,焊接层:0.3±0.Ιμπι。否则将达不到要求的抗腐蚀性和耐磨性能。
发明内容
[0005] 本实用新型要解决的技术问题是:克服现有技术的不足,提供一种成本降低的一种智能卡封装框架。
[0006] 本实用新型解决其技术问题所采用的技术方案是:该智能卡封装框架,包括基材、基材上方的接触层和基材下方的焊接层,所述接触层和焊接层均为复合结构,自内向外依次为铜层、镍层和金层,其特征在于:在所述镍层与金层之间增加一层磷镍合金层。即接触层和焊接层均为四层复合结构,自内向外依次为铜层、镍层、磷镍合金层和金层。
[0007] 所述的接触层的镍层厚度为1.8~2.2
μm,磷镍合金层厚度为0.4~0.8 μm,金层厚度为 0.009~0.05 μm。
[0008] 所述的焊接层镍层与磷镍合金层总厚为5±2
μm,金层厚度为0.3±0.1
μm。
[0009] 接触层的金层为金钴合金的硬金层。
[0010] 所述的磷镍合金层中磷占质量分数为4°~8%,余量为镍。
[0011] 本实用新型制作过程中在电镀工序进行了镍、金2种金属镀层的电镀,主要影响的是产品的外观以及厚度,对产品的功能性起着决定性的影响。影响产品耐腐蚀以及耐磨性的主要是产品的接触层。
[0012] 铜层是基层,再电镀电镀镍,磷镍,金。其中金在正反面的成分不同,因为正反面功能性不同,其中接触层的金层为金钴合金的硬金层,焊接层的金层为软金层。
[0013] 本实用新型一种智能卡封装框架的制作流程为:除油、活化、电镀半光亮镍、电镀磷镍合金、预镀金、镀硬金、镀软金、热水洗、烘干。与传统工艺相比,本实用新型的制作过程加入了电镀磷镍合金,取消了后处理的使用。
[0014] 由于智能卡封装框架具有高精密性与严格的外观要求。本实用新型将电镀磷镍合金应用于智能卡封装框架工艺,与传统的半光亮镀镍相比,磷镍合金的镀层致密性更加良好,有良好的耐腐蚀性和抗磨耗的物理特性。本实用新型以一个最佳的磷镍厚度值,减少智能卡接触层的硬金膜厚,并且取消常规工艺的后处理,即封孔工艺,利用磷镍合金的优势镀层性能,来替代原常规工艺的为得到表面保护效果所做的措施,来减少生产成本,在之后进行的96h盐雾试验,产品的表现非常好,通过了盐雾试验,表示其抗腐蚀性完全达到要求:并且焊接层的焊线性能良好,完全无任何不良影响。
[0015] 与现有技术相比,本实用新型的一种智能卡封装框架所具有的有益效果是:
1.用磷镍合金替换原半光亮镍的中间层,提高了产品接触表面的耐磨性和抗腐蚀性。我们采取电流密度,温度,PH条件的对磷镍合金来说,可以避免磷镍合金有漏镀以及烧焦的可能性,取得性能良好的镀层。通过测试发现,镍与磷镍层结合牢固,无镀层可能会分离的可能性。
2.由于磷镍合金镀层的高致密性,所以产品具有良好的物理性能以及化学性能。智能卡的表面接触的硬金层以及工艺中的后处理措施的目的就是对产品的一种保护作用,而采用了磷镍合金,相应的可以减少硬金的厚度,并取消后处理的使用,大大节约成本。在进行的一系列测试中,去除了后处理以及减少硬金膜厚的产品,盐雾试验表现良好。
附图说明
[0016] 图1是一种智能卡封装框架的层状结构示意图.[0017] 其中1、铜层2、镍层3、磷镍合金层4、金层5、基材。
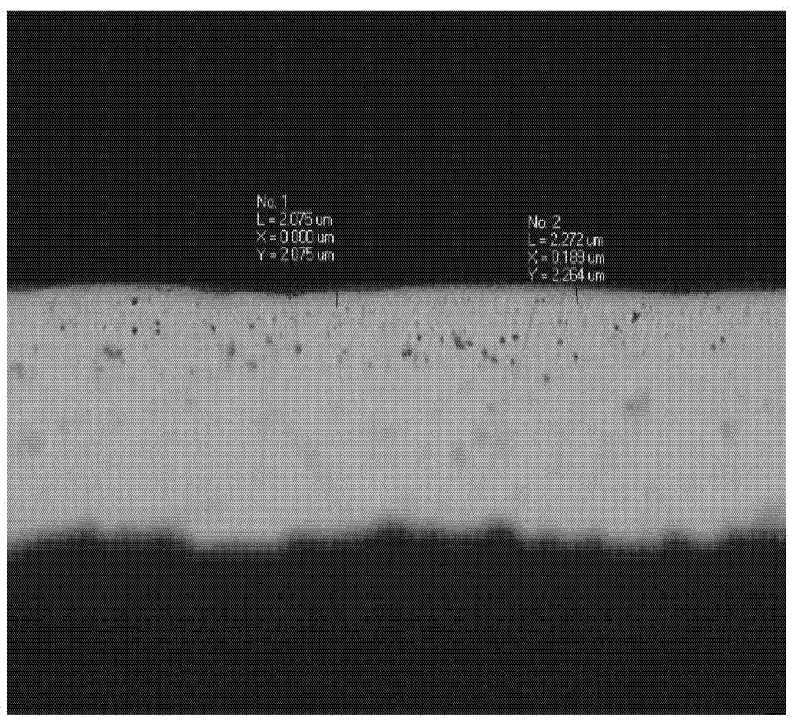

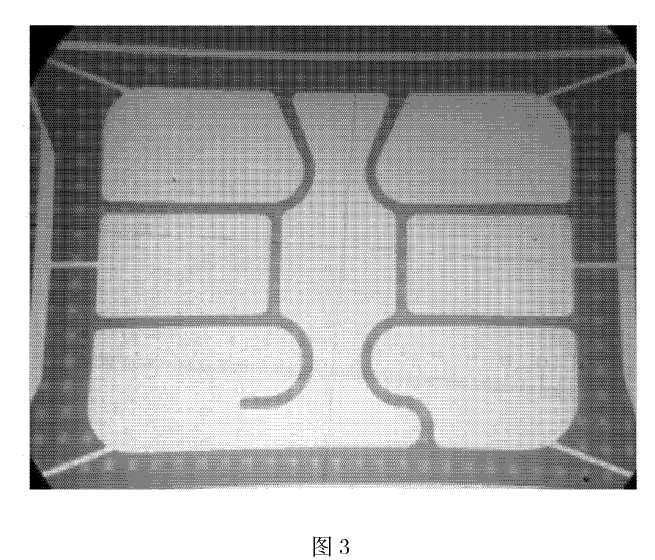

具体实施 方式
[0018] 下面通过具体实施例对本实用新型一种智能卡封装框架做进一步说明,其中实施例I为最佳实施例。
[0019] 实施例1
[0020] 一种智能卡封装框架,所述的智能卡封装框架的接触层和焊接层均为四层结构,接触层和焊接层之间为基材5,基材5两侧自内向外依次为铜层1、镍层2、磷镍合金层3、金层4
;其中接触层的镍层2厚度为2.0 μ m,磷镍合金层3厚度为0.4 μ m,硬金层4厚度为0.025 μ m;焊接层镍层2与磷镍合金层3总厚为5 μ
m,软金层4厚度为0.3 μ m。所述的磷镍合金层3中磷占质量分数为6%。
[0021] 实施例2
[0022] 一种智能卡封装框架,所述的智能卡封装框架的接触层和焊接层均为四层结构,接触层和焊接层之间为基材5,基材5两侧自内向外依次为铜层1、镍层2、磷镍合金层3、金层4
;其中接触层的镍层2厚度为2.2 μ m,磷镍合金层3厚度为0.42 μ m,金层4厚度为0.035 μ m ;焊接层镍层2与磷镍合金层3总厚为5.5 μ
m,软金层4厚度为0.32 μ
m。所述的磷镍合金层3中磷占质量分数为7%。[0023] 实施例3
[0024] 一种智能卡封装框架,所述的智能卡封装框架的接触层和焊接层均为四层结构,铜层附着在基材5上,基材5两侧自内向外依次为铜层1、镍层2、磷镍合金层3、金层4;其中接触层的镍层2厚度为2.0
μ m,磷镍合金层3厚度为0.35 μ m,硬金层4厚度为0.028 μ m ;焊接层镍层2与磷镍合金层3总厚为4.5 μ m,软金层4厚度为0.28 μ
m。所述的磷镍合金层3中磷占质量分数为5%。
[0025] 实施例4
[0026] 一种智能卡封装框架,所述的智能卡封装框架的接触层和焊接层均为四层结构,铜层附着在基材5上,基材5两侧自内向外依次为铜层1、镍层2、磷镍合金层3、金层4
;其中接触层的镍层2厚度为2.0 μ m,磷镍合金层3厚度为0.5 μ m,硬金层4厚度为0.05 μ m ;焊接层镍层2与磷镍合金层3总厚为7
4!11,软金层4厚度为0.44111。所述的磷镍合金层3中磷占质量分数为8%。
[0027] 实施例5
[0028] 一种智能卡封装框架,所述的智能卡封装框架的接触层和焊接层均为四层结构,铜层附着在基材5上,基材5两侧自内向外依次为铜层1、镍层2、磷镍合金层3、金层4
;其中接触层的镍层2厚度为L 8 μ m,磷镍合金层3厚度为0.3 μ m,硬金层4厚度为0.009 μ m
;焊接层镍层2与磷镍合金层3总厚为3μπι,软金层4厚度为0.2μπι。所述的磷镍合金层3中磷占质量分数为4%。
[0029] 实施例6
[0030] 一种智能卡封装框架,所述的智能卡封装框架的接触层和焊接层均为四层结构,铜层附着在基材5上,基材5两侧自内向外依次为铜层1、镍层2、磷镍合金层3、金层4
;其中接触层的镍层2厚 度为2.0 μ m,磷镍合金层3厚度为0.5 μ m,硬金层4厚度为0.025 μ m ;焊接层镍层2与磷镍合金层3总厚为7
4!11,软金层4厚度为0.44111。所述的磷镍合金层3中磷占质量分数为17%。
[0031] 本实用新型的具体电镀工艺为:其中活化盐使用得力有限公司(Technic)的Act9600活化盐或昆山轩亨贸易有限公司ZA-200微蚀剂。其中40CS导电盐、80orosene-RC开缸剂#l、80orosene-RC开缸剂#2、80orosene_RC光亮剂、S-1添加剂、434HS导电盐、434HS电解添加剂、434HS添加剂A、S_1添加剂均为得力有限公司(Technic)生产型号;镍湿润剂,镍柔软剂,磷镍合金添加剂由昆山轩亨贸易有限公司提供。
[0032] 1、除油:采用了超声振荡以及电解除油的工艺对成型框架的铜面做除油处理,使用碱性除油粉,配制浓度为70g/L的溶液,温度为55°C条件下,控制电解除油电流密度为10ASD
;浸溃时间为18s
;
[0033] 2、活化:对除油后的铜面做活化处理,采用的70g/L的ZA-200微蚀剂与质量分数3%的硫酸混合溶液,温度35°C条件下浸溃时间为12s
;
[0034] 3、镀镍:在成型框架接触层的铜面电镀1.8^2.2 μ
m厚的镍层,电镀药水成分为氨基磺酸镍100g/L,氯化镍10g/L,硼酸35g/L,镍柔软剂4ml/L,镍湿润剂3ml/L
;PH=3.8,温度为60°C,电流密度控制在1(T30ASD,浸溃时间48s ;
[0035] 4、电镀磷镍:在镍层的基础上电镀0.4^0.8 μ
m的磷镍合金层,,电镀药水成分为氨基磺酸镍100g/L,氯化镍40g/L,硼酸35g/L,20%的亚磷酸溶液50ml/L,温度为50°C,PH=L
5,电流密度控制在5?15ASD。相同药水在第二接触层铜面上电镀总厚5±2 μ
m的镍层与磷镍合金层,浸溃时间48s;
[0036] 5、预镀金:药水成分为含金量2g/L,使用40CS导电盐控制比重9,PH=4.0,温度450C
;浸溃时间9s,电流密度0.3ASD ;
[0037] 6、镀硬金:在接触层磷镍合金层外电镀厚度为0.009、.05 μ
m的硬金层,药水成分为含金量5g/L,使用80orosene-RC开缸剂#1控制比重15,80orosene-RC开缸剂#2为30g/L,80orosene-RC
光亮剂控制 Co 含量在 1.0g/L, S-1 添加剂 4ml/L, PH=4.7,温度为60°C,浸溃时间12s,电流密度0.2^0.72ASD
;
[0038] 7、镀软金:在焊接层磷镍合金层外电镀厚度为0.2^0.4 μ
m的软金层,药水成分含金量8g/L,使用434HS导电盐控制比重在14,434HS电解添加剂30g/L,434HS添加剂A 2ml/L,S-1添加剂3ml/L
;PH=6.0,温度为65°C,浸溃时间12s,电流密度为2?4ASD。
[0039] 以上所述,仅是本实用新型的较佳实施例而已,并非是对本实用新型作其它形式的限制,任何熟悉本专业的技术人员可能利用上述揭示的技术内容加以变更或改型为等同变化的等效实施例。但是凡是未脱离本实用新型技术方案内容,依据本实用新型的技术实质对以上实施例所作的任何简单修改、等同变化与改型,仍属于本实用新型技
术方案的保护范围。
原文地址:http://www.cnblogs.com/heiyue/p/3761767.html